SiC SBDの特徴(what2)
SiC-Halbleiter
<Arten von SiC-Leistungshalbleitern>
SiC SBD Gerätestruktur und Merkmale
Die Integration der SiC-Hochgeschwindigkeits-Gerätekonstruktion in Schottky-Dioden (SBD) ermöglicht es, Stehspannungen von über 600 V zu erzielen (im Gegensatz zu ~200 V mit Silizium-SBD).
Infolgedessen reduziert der Austausch der bestehenden PN-Sperrschicht-Dioden der Hauptströmung (Typ der schnellen Wiederherstellung) den Erholungsverlust erheblich und trägt zu einem geringeren Geräuschpegel und einer gesteigerten Kompaktheit in passiven Komponenten wie Spulen bei aufgrund der gesteigerten Effizienz der Stromversorgung und des Betriebs mit höheren Frequenzen.
Dies stellt eine Unterstützung von Blindleistungskompensations-Schaltungen (PFC) und Gleichrichterbrücken sicher, da sich diese nun für eine breitere Reihe an Anwendungen, einschließlich Wechselstrom, Stromversorgung, Solar Power Conditioner und Schnellladung von Elektrofahrzeugen, eignen.

SiC-SBD-Durchlass-Eigenschaften
Der Spannungsanstieg von SiC SBDs beträgt weniger als 1 V - entsprechend dem von FRDs.
Der Spannungsanstieg wird von der Höhe der Schottky-Barriere bestimmt. Obgleich es eine niedrigere normale Barrierenhöhe ermöglicht, den Spannungsanstieg zu reduzieren, erfolgt dies auf Kosten des Leckstroms, der sich während der Sperrvorspannung erhöht. Als Antwort darauf hat ROHM erfolgreich einen Prozess für seine 2. Generation an SBD entwickelt, der den Spannungsanstieg um circa
0,15 V reduziert, während gleichzeitig der Leckstrom und die Wiederherstellungseigenschaften äquivalent zu denen von konventionellen Produkten bleiben.
Darüber hinaus weicht die Temperaturabhängigkeit erheblich von SiFRDs ab, während Vf mit dem Betriebswiderstand bei höheren Temperaturen steigt.
Dies hilft dabei, ein thermisches Durchgehen zu verhindern, wodurch ein sorgenfreier Betrieb auch bei parallelem Anschluss sichergestellt wird.
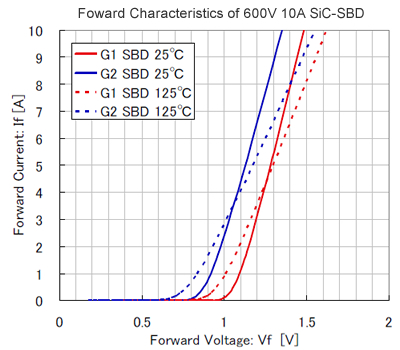
Eigenschaften in Bezug auf die Sperrverzögerung von SiC SBD
Bei Hochgeschwindigkeits-PN-Dioden aus Silizium (FRD) fließen hohe transiente Ströme ab dem Zeitpunkt, an dem sich die Richtung von vorwärts nach rückwärts ändert, was zu großen Verlusten führen kann, wenn während dieser Zeit auf eine Sperrvorspannung umgeschaltet wird.
Wenn Durchlassstrom anliegt, tragen die Minoritätsträger, die sich in der Driftschicht angesammelt haben, zur elektrischen Leitfähigkeit bei, bis sie verschwinden (Speicherzeit). Dies steigert sowohl die Wiederherstellungszeit als auch den Erholungsstrom, da der Durchlassstrom und die Temperatur ansteigen, was zu erheblichen Verlusten führt.
Im Gegensatz dazu sind SiC SBD Majoritätsträgergeräte (unipolar), die keine Minoritätsträger für die elektrische Leitfähigkeit verwenden, so dass es grundsätzlich zu keiner Ansammlung von Minoritätsträgern kommt. Infolgedessen fließt nur eine geringe Menge Strom zur Entladung der Sperrschichtkapazität, wodurch ein erheblich geringerer Verlust als bei Silizium-FRDs erzielt wird.
Dieser transiente Strom ist von Temperatur und Durchlassstrom größtenteils unabhängig, wodurch eine stabile Hochgeschwindigkeits-Wiederherstellung in so gut wie jeder Umgebung möglich wird. Eine Reduzierung des Lärms, der aufgrund des Sperrverzögerungsstroms auftritt, kann auch erwartet werden.
Sperrverzögerungs-Wellenform (600 V 10 A)
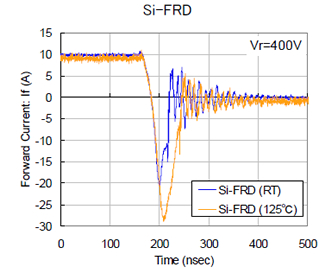
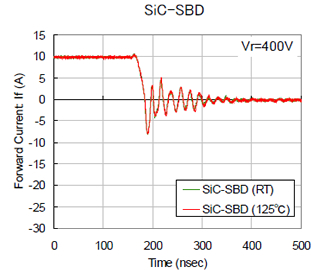
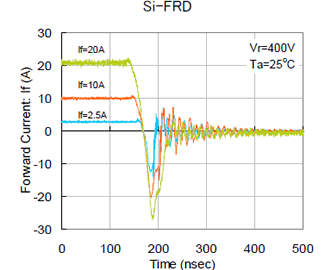
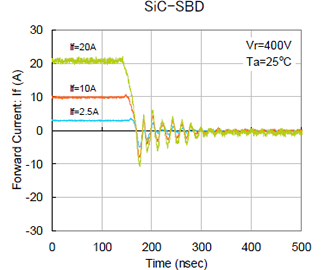
SiC MOSFET Gerätestruktur und Merkmale
Bei Silizium kommt es bei einem Anstieg der Stehspannung auch zu einer Steigerung des Widerstands pro Einheitsfläche (etwa um das Quadrat zur 2,5. Leistung der Stehspannung). Aus diesem Grund werden primär IGBTs (Insulated Gate Bipolar Transistors, bipolare Isolierschicht-Transistoren) für Spannungen über 600 V eingesetzt.
IGBTs können geringere ON-Widerstände als MOSFETs bieten, durch Leitfähigkeitsmodulation an den Stellen, an denen Minoritätsträger (Löcher) in die Driftschicht injiziert werden. Dies führt jedoch zur Erzeugung von Tailstrom während der Abschaltung, der von der Ansammlung von Minoritätsträgern verursacht wird, was wiederum größere Schaltverluste zur Folge hat.
Im Vergleich dazu weisen SiC einen geringeren Driftschicht-Widerstand auf als Silizium-Geräte, wodurch der Bedarf nach einer Leitfähigkeitsmodulation eliminiert und eine hohe Stehspannung mit geringem Widerstand bei Nutzung in Hochgeschwindigkeitsgeräten wie MOSFETs ermöglicht wird.
Da im Grunde kein Tailstrom erzeugt wird, sollte ein Austausch der IGBTs durch SiC MOSFETs daher den Schaltverlust erheblich reduzieren, und eine Verringerung der Größe der Gegenmaßnahmen zur Kühlung wird ermöglicht.
Der Einsatz von SiC trägt durch den Hochfrequenzbetrieb ferner zu kleineren passiven Komponenten bei, die mit konventionellen IGBT-Lösungen nicht möglich sind. 600 V-900 V SiC MOSFETs bieten eine Reihe an zusätzlichen Vorteilen, einschließlich einem kleineren Chip-Bereich (wodurch kleinere Module ermöglicht werden) und einem erheblich geringeren Erholungsverlust. Infolgedessen hat sich die Anwendung ausgedehnt und umfasst nun auch die Leistungsversorgung industrieller Anlagen und Wechselrichter/ Wandler für hocheffiziente Leistungskonditionierer.

Normalisierter ON-Widerstand
SiC bietet das 10-fache der nicht leitenden elektrischen Durchbruchfeldstärke von Silizium, wodurch es ermöglicht wird, höhere Durchbruchspannungen durch geringere Widerstandsgröße und eine dünnere Driftschicht zu erzielen. .
Dies ermöglicht einen geringeren normalisierten ON-Widerstand (ON-Widerstand pro Einheitsfläche) bei derselben Stehspannung.
Bei 900 V und demselben ON-Widerstand kann die Chipgröße beispielsweise um das 35-fache gegenüber Silizium-MOSFETs und das 10-fache gegenüber SJ MOSFETs reduziert werden. Neben der Bereitstellung eines geringen ON-Widerstands in einem kompakten Formfaktor können auch die Gate-Ladung Qg und die Kapazität reduziert werden.
Normalerweise sind die SJ MOSFETs mit Stehspannungen von nur bis zu 900 V erhältlich.
Die Nutzung von SiC ermöglicht jedoch Spannungen über 1700 V mit geringem ON-Widerstand.
Tatsächlich macht SiC es möglich, Geräte zu entwickeln, die einen geringen ON-Widerstand, eine hohe Stehspannung und Hochgeschwindigkeitsschaltung kombinieren, wodurch der Bedarf an bipolaren Geräten wie IGBT (die einen geringen ON-Widerstand, aber langsame Schaltgeschwindigkeiten bieten) eliminiert wird.
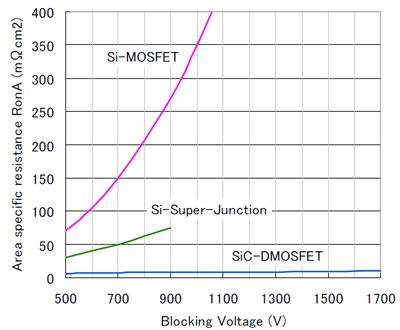
Vd-Id Eigenschaften
SiC MOSFETs weisen keinen Spannungsanstieg auf, wie es bei IGBT der Fall ist, was zu einem geringen Leitungsverlust über den gesamten Strombereich führt. Darüber hinaus steigert sich der ON-Widerstand von Si MOSFETS bei Raumtemperatur um 100 % bei 150 C.
Mit SiC MOSFETs ist die Anstiegsrate jedoch relativ gering, wodurch das thermische Design vereinfacht wird, während gleichzeitig ein geringer ON-Widerstand selbst bei hohen Temperaturen sichergestellt wird.
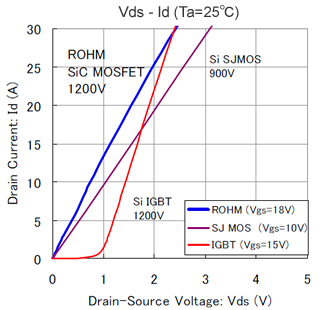
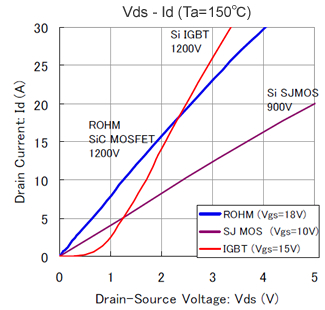
*Die Daten zeigen die Ergebnisse von Bewertungen an, die von ROHM unter denselben Bedingungen durchgeführt wurden
Antriebs-Gate-Spannung und ON-Widerstand
Obgleich die SiC MOSFETs einen geringeren Drift-Widerstand aufweisen als Si MOSFETs, ist die Mobilität des MOS-Kanalabschnitts auf dem aktuellen technischen Stand gering, was zu einem höheren Widerstand des MOS-Kanals führt.
Dies macht es möglich, einen geringeren ON-Widerstand bei höheren Gate-Spannungen zu erzielen (schrittweise Sättigung bei Vgs=20 V+).
Jedoch kann keine inhärente ON-Widerstandsleistung bei Antriebsspannungen gezeigt werden, die für standardmäßige IGBTs und Si MOSFETs (Vgs=10-15 V) verwendet werden. Daher wird für den Erhalt eines ausreichenden ON-Widerstands eine Antriebsspannung um Vgs=18 V empfohlen.
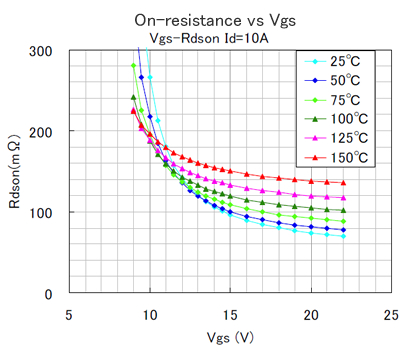
electronics_tips_menu






