Dünnschicht-Piezo-MEMS-Produktion
In der Forschung und Entwicklung konzentriert sich ROHM seit vielen Jahren auf technologische Innovationen unter Verwendung von Ferroelektrika. Die Dünnfilm-Piezo-MEMS-Produktionsstätte von ROHM verfügt über eine eigene, hochzuverlässige Produktionsanlage, die auf marktbewährtem ferroelektrischen Fachwissen basiert, sowie über ein heterogenes Materialmanagementsystem, das die Integration von piezoelektrischen MEMS-Dünnfilm- und IC-Mikrofabrikationstechnologien ermöglicht. Gleichzeitig ermöglicht die gemeinsame Entwicklung den Kunden, Lösungen der nächsten Generation zu entwickeln, die eine bahnbrechende Miniaturisierung mit beispiellosen Energieeinsparungen und Leistungen bieten.
Was ist "Piezo"? Was ist MEMS? -Elektronik-Grundlagen
Hier erläutern wir die Grundlagen von Piezos und MEMS, ihre Merkmale und Anwendungen sowie ihren Aufbau und ihre Eigenschaften.
Entwicklungs- und Serienproduktionsaufträge
Wichtigste Technologien und Dienstleistungen.
Wir bieten umfassende Unterstützung vom Prototyping und der Entwicklung bis hin zur Massenproduktion, einschließlich der Prozessplanung für MEMS-Bauteile auf Silizium- und SOI-Wafern, der Herstellung hochleistungsfähiger piezoelektrischer Folien sowie der Vergabe von Unteraufträgen und der Unterstützung bei der Entwicklung von piezoelektrischen MEMS-Bauteilen. Nehmen Sie Kontakt mit uns auf, um individuelle Prozesse zu besprechen, die nicht auf unserer Website oder in unseren Katalogen aufgeführt sind.
Dünnschicht-Piezotechnik

- ・Sol-gel PZT
- ・PZT Dotierung
- ・Kontrolle der Kristallinität, usw.
Halbleiter-Prozesstechnologien

- ・Lithographie
- ・Ätzen
- ・Sputtern, usw.
MEMS-Verfahrenstechnik

- ・Bonding auf Wafer-Ebene
- ・Silizium-Tiefätzung
- ・Atomlagenabscheidung (ALD)
- ・Dicing, usw.
Technologie zur Handhabung dünner Wafer

- ・Unterstützung des Waferprozesses
- ・Spezielle Reinigung
- ・Laminieren, usw.

Massenproduktion und Entwicklungslinien
Im Werk Miyazaki von LAPIS Semiconductor wird eine 6-Zoll-MEMS-Linie gebaut, die die proprietäre Dünnfilm-Piezotechnologie in eine LSI-Produktionslinie integriert.
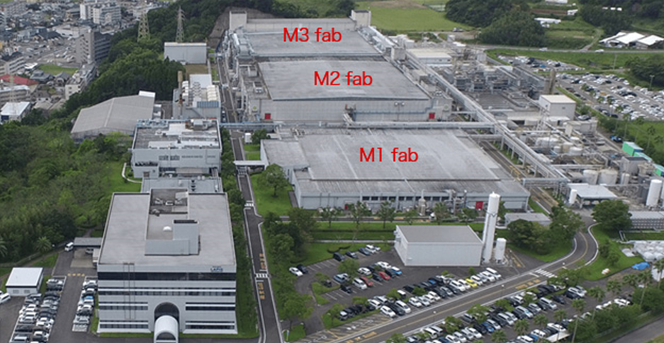
| Standort | Kiyotake-cho, Miyazaki-Stadt, Präfektur Miyazaki, Japan |
|---|---|
| Reinraum | Spezieller Piezo-MEMS-Bereich 1,360m2 |
| Sauberkeit | Class 1-1,000 |
| Wafer-Durchmesser | 6 Zoll |
| Angebotene Dienstleistungen | Entwicklungsmuster, Prototyping, Massenproduktion |
| ISO-Zertifizierungen | ISO9001, ISO14001 |
| Erfahrung in der Entwicklung/Volumenproduktion | Aktuatoren, Sensoren |
| Verfahrenstechnik | PZT-Piezo-Dünnschicht, doppelseitige Si-Verarbeitung, Wafer-to-Wafer-Bonding |
Prozess von der Kundenberatung bis zur Massenproduktion
Unsere Produktionsanlagen mit spezieller MEMS-Linie ermöglicht es uns, alles vom Prototyping bis zur Massenproduktion von Kundenprodukten abzuwickeln.

*Der obige Ablauf ist nur ein Beispiel. Der tatsächliche Ablauf wird in jedem Einzelfall nach Rücksprache festgelegt.
Für Anfragen, Anträge und/oder Beratung können Sie das Formular auf der Kontaktseite ausfüllen.
Hausinterne Ausrüstung
Durch die Installation der erforderlichen Ausrüstung und Analysewerkzeuge für MEMS-Prozesse in unserer Fertigungslinie können wir Prozesse für eine breite Palette von Geräten und Initiativen zur Qualitätsverbesserung vorschlagen.
| Prozessklassifizierung | Ausrüstung |
|---|---|
| Schichtaufbringung | |
| Sol-Gel (PZT-basiert) | |
| PE-CVD (SiO2, SiN) | |
| LP-CVD (SiO2, SiN, poly-Si) | |
| Thermischer Oxidationsofen | |
| Sputtern (Pt, Ir, IrO2, AlCu, Ti, TiN usw.) | |
| Atomlagenabscheidung (ALD) (Al2O3, SiO2, Ta2O5) |
|
| Aufbringen einer wasserabweisenden Beschichtung | |
| Photolithographie | |
| Resistbeschichtung / Entwicklung | |
| MPA (Mirror Projection Aligner) | |
| Doppelseitige Ausrichtgeräte, IR-Stepper, i-line-Stepper | |
| Trockenätzung | |
| Si-Tiefätzung | |
| Zwischenschichtmembran RIE-Ausrüstung | |
| ICP-Ätzen für PZT und Elektroden | |
| Nassätzung | |
| Ätzen von Siliziumoxid | |
| Au-Ätzen | |
| Anisotropes Ätzen von Si | |
| Wafer-Bonding | |
| Kunstharz-Bonding | |
| Anodisches Bonding |
| Prozessklassifizierung | Ausrüstung |
|---|---|
| Laminierung | |
| Automatische Wafer-Laminiermaschine (UV-Band, thermische Trennfolie, Polyimid, etc.) |
|
| Abisolieren und Reinigen | |
| Asher | |
| Organische und polymere Abbeizmittel | |
| Saure Reinigung, Scrubber | |
| Aufteilung, etc. | |
| Dicing, Zweiflüssigkeitsreinigung | |
| Kreisschneider | |
| Messung | |
| Analyse / Messung SEM, Ionenfräsen | |
| Optisches Längenmessgerät | |
| Oberfläche-zu-Oberfläche-Verschiebungsmessgerät | |
| Sichtbares Licht / IR / Laser-Mikroskope | |
| Röntgen-Diffraktometer | |
| Laser-Verschiebungsmessgerät | |
| Röntgenfluoreszenzspektrometer (XRF) | |
| Optisches Interferenz-Messgerät | |
| Ellipsometer | |
| Automatisches visuelles Inspektionssystem (für die Vorder- und Rückseite von Wafern) | |
| Verschiedene Geräte zur elektrischen Charakterisierung (Sonden, Prüfgeräte) |

Prozessfähigkeit
Nehmen Sie Kontakt mit uns auf, um individuelle Verfahren zu besprechen, die nicht auf unserer Website oder in unseren Katalogen aufgeführt sind.
| Herstellungsverfahren | Prozessspezifikation | numerischer Wert | Bemerkungen |
|---|---|---|---|
| Photolithographie | Mindestlinienbreite (mit Stepper) Mindestlinienbreite (mit Aligner) |
1μm 3μm |
|
| Si-Tiefätzung | Kegelwinkel Gleichmäßigkeit der Ätzrate in der Ebene Maßgenauigkeit |
90+/−1˚ ≤5% +/−0.1μm (beide abhängig vom Muster) |
Bearbeitung durch Substrat möglich Bearbeitung auf beiden Seiten (Vorder-/Rückseite) möglich (kerbfrei) Optionale Konussteuerung |
| TMAH-Ätzen | Tiefe | ≤5% in der Ebene | Bearbeitung durch Substrat möglich Vorder- und Rückseiten können bearbeitet werden |
| PZT-Abscheidung | Genauigkeit der Schichtdicke | Im Wafer: +/−1.0% Zwischen Wafern/Lots: +/−2.5% |
Dopingbeispiele (Nb, La) |
| PZT-Ätzen | Genauigkeit der Bearbeitungslinienbreite Gleichmäßigkeit der Ätzrate in der Ebene |
+/−1μm ≤5% (PZT-Dicke −3μm, mit kegelförmiger Geometrie) |
Pt-Stopp möglich |
| Sputtern | Gleichmäßigkeit der Schichtdicke | ≤4% in der Ebene | Pt, Ir, IrO2, AlCu, Ti, TiN, usw. |
| CVD | Gleichmäßigkeit der Schichtdicke | ≤4% in der Ebene | SiO2, SiN |
| ALD | Gleichmäßigkeit der Schichtdicke | ≤5% in der Ebene | Al2O3, Ta2O5, SiO2 |
| Kunstharz-Bonding | Ausrichtungsgenauigkeit Dicke des Harzes |
+/−5μm 1 to 3μm |
Epoxid, BCB |
| Anodisches Bonding | Dichtender Innendruck | >0.01Pa | Si- / Glas |
Beispiele für die Ergebnisse der Prototypen- und Massenproduktion
Basierend auf unserer Erfahrung in der Massenproduktion von Tintenstrahlköpfen und unserer Untersuchung der MEMS-Technologie arbeiten wir mit unseren Kunden zusammen, um Prototypen von Aktuatoren zu entwickeln und zu evaluieren, die kompakt, stromsparend und mit hoher Auslenkung operieren müssen.
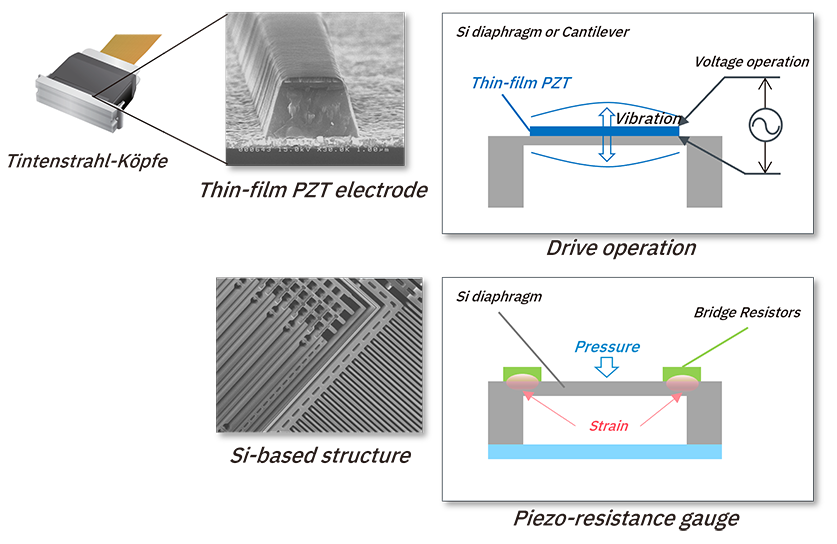
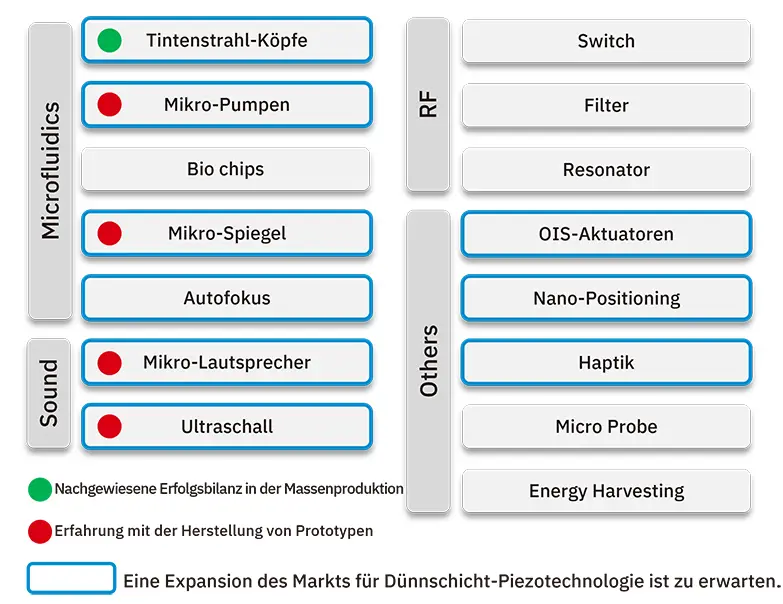
Beispiele für Verfahrenstechnik
Leistung von PZT-Dünnschichten
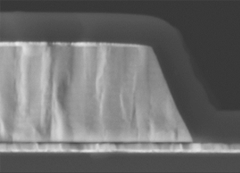
[PZT Stack Cross-Section]
ROHM gelang es 1998, den weltweit ersten ferroelektrischen Speicher in Serie zu produzieren.
Das Unternehmen verfügt über langjährige Erfahrung und Know-how bei der Verwendung von PZT-Dünnschichten auf Siliziumwafern.
Die Sol-Gel-PZT-Filme von ROHM werden in eigens entwickelten Produktionsanlagen abgeschieden, um das weltweit höchste Niveau an piezoelektrischer Leistung und Zuverlässigkeit zu erreichen.
| Parameter | Wert | Bedingungen und Konditionen |
|---|---|---|
| Piezoelektrische Konstante: e31,f (−C/m2) | 19 | 10V/μm |
| Konstante Rückwärtsspannung: d31 (−pm/V) | 260 | 10V/μm |
| Durchschlagsfestigkeit: (V/μm) | >75 | Raumtemperatur (eingeschränkt durch Auswertungsnetzteil) |
| Isolationsdauer: (Jahre) | >10 | 20V/μm, 105˚C, (Schätzung durch Beschleunigungstests) |
| Lebensdauer der Wiederholungen: (mal) | >1x1010 | 10V/um, Auslenkung um 10% reduziert (unipolarer Impuls) |
| Ableitstromdichte: (A/cm2) | <1x10−7 | 20V/μm |
Wafer-Level-Bonding-Technologie
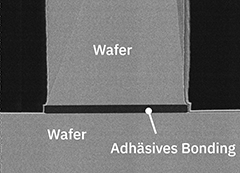
[Querschnitt der Waferverbindung]
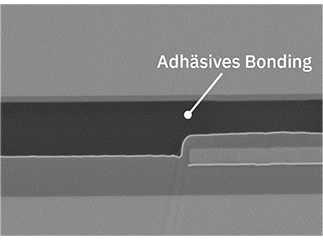
[Querschnitt der Waferverbindung / Stufenregion]
Mehrere Technologien ermöglichen es uns, das Bonding auf Wafer-Ebene auch für Produkte mit komplexen Strukturen durchzuführen.
*Wir bieten auch adhäsives Aufbringen und Bonding an.
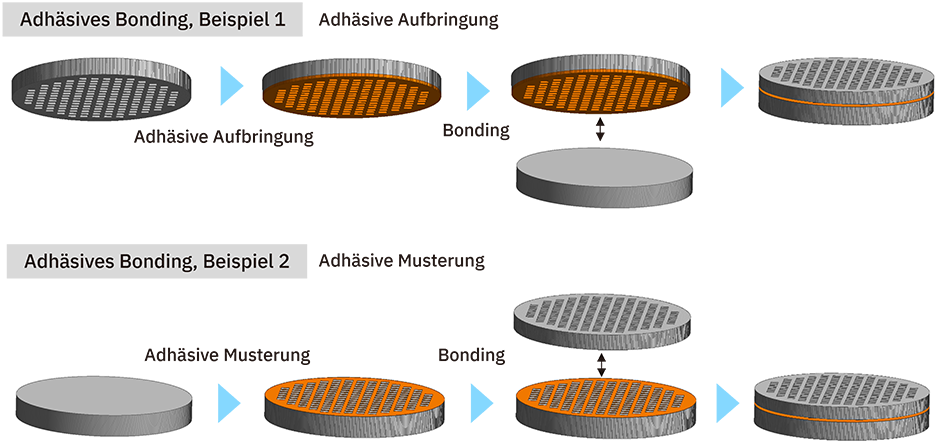
Si-Tiefätzung

[400μm Si-Durchdringung]

[Silizium-Wafer-Verarbeitung]
Wir verfügen über Si-Tiefätzanlagen verschiedener Unternehmen, darunter auch solche, die wir selbst entwickelt haben, und können Ihnen das optimale Silizium-Ätzverfahren (Form, Toleranzen, Verschmutzungsgrad, Kosten) für Ihr Produkt vorschlagen.

Technologie zur Handhabung dünner Wafer

[Dünner Silizium-Wafer]
Eine in unserem Hause entwickelte Wafer-Transferanlage ermöglicht Prozesse und Wafer-Bonding mit dünnen Silizium-Wafern.


[Wafer mit TAIKO-Schleifung]

ALD-Schutzfilmbildung
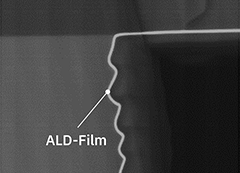
[Querschnitt der Siliziumform]
Selbst bei Geräten mit komplexer, ungleichmäßiger Geometrie kann ALD* eine einheitliche Schutzschicht bilden.
*ALD = Atomic Layer Deposition (Atomlagenabscheidung)
Schutzfolie: Schützt Geräte vor äußeren Einflüssen (z. B. Tinte, Abrieb durch Berührung, statische Elektrizität)
Eine ausführliche Erklärung der Atomlagenabscheidung (ALD) finden Sie hier. -Elektronik-Grundlagen
Simulationsanalyse von piezoelektrischen Bauelementen
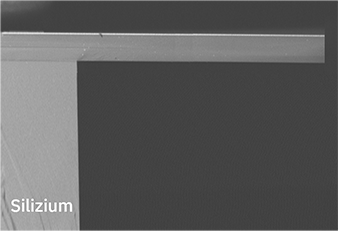
[Querschnitt eines Silizium-Auslegers]
Es können Finite-Elemente-Simulationen von piezoelektrischen Bauteilen durchgeführt und optimale Strukturen und Verfahren für verschiedene Bauteile vorgeschlagen werden.